SD NAND的LGA封装和BGA封装有什么
LGA与BGA封装的主要区别在于焊接方式与结构特性。LGA采用平整焊盘,需精确控制锡膏量,具有更薄更小的优势,但焊接难度较高;BGA自带锡球,焊接工艺更简单,且能更好吸收热应力。在可靠性方面,LGA电气性能更优,而BGA耐热循环能力更强。SDNAND选择LGA封装主要是为了满足微型化需求,其0.8mm超薄特性特别适合穿戴设备等空间受限场景。两种封装各有特点:LGA在尺寸上占优,BGA在工艺便利性上
SD NAND通常采用LGA封装,而很多其他存储芯片如eMMC、NAND Flash则常用BGA封装。这两种封装有什么区别?对设计和生产有什么影响?
LGA是Land Grid Array的缩写,中文叫栅格阵列封装。它的特点是焊盘在芯片底部,是平整的金属表面,没有凸起的锡球。焊接时需要在PCB焊盘上涂锡膏,然后把芯片放上去,通过回流焊使锡膏熔化,连接芯片和PCB。
BGA是Ball Grid Array的缩写,中文叫球栅阵列封装。它的特点是芯片底部有微小的锡球,焊接时把芯片对准PCB焊盘,通过回流焊使锡球熔化,连接芯片和PCB。
两种封装的主要区别有几点。
第一是焊接难度。LGA封装没有锡球,对锡膏的量和均匀性要求较高。锡膏涂多了可能短路,涂少了可能虚焊。BGA封装的锡球是统一成型的,焊接相对容易,但需要X光检查焊点质量。总体来说,LGA和BGA都需要专业的SMT设备和工艺控制,不建议手工焊接。
第二是PCB焊盘设计。LGA封装的焊盘是平整的,PCB上对应的是同样形状的焊盘。BGA封装的PCB焊盘通常是圆形的,直径略小于锡球直径。两种封装的焊盘设计规则不同,不能直接互换。
第三是可靠性。LGA封装的焊点更薄,电气性能更好,但热应力承受能力可能略低于BGA。BGA封装的锡球有一定高度,可以吸收热膨胀产生的应力,在温度循环测试中表现更好。米客方德SD NAND的LGA封装经过充分的热循环测试,在工业温度范围内可靠性有保障。
第四是尺寸。LGA封装可以做到更薄,因为没有锡球的高度。米客方德6x8mm SD NAND的厚度只有0.8mm左右,非常适合空间受限的设备。BGA封装因为有锡球,总厚度通常会大一些。
第五是返修难度。LGA封装的返修需要重新涂锡膏,操作比BGA复杂。BGA封装返修时可以用植球台重新植球,相对容易一些。不过无论是LGA还是BGA,返修都需要专业设备和技术,不建议手工操作。
米客方德为什么选择LGA封装?主要是为了小尺寸。SD NAND的应用场景对尺寸要求很高,LGA可以做到更小更薄,满足智能穿戴、便携医疗等设备的需求。
对于工程师来说,使用LGA封装的SD NAND时要注意几点:PCB焊盘设计要严格按照数据手册的推荐尺寸;钢网开口要优化,确保锡膏量合适;回流焊炉温曲线要符合规范;有条件的话用X光检查焊点质量。
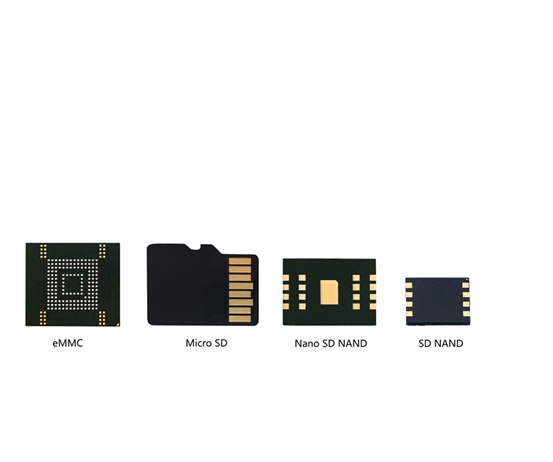
总结来说,LGA和BGA各有优劣。LGA更薄、更小,适合尺寸敏感的应用;BGA焊接相对容易,返修更方便。米客方德SD NAND采用LGA封装,是为了在保证可靠性的前提下,把尺寸做到最小。
更多推荐
 已为社区贡献6条内容
已为社区贡献6条内容






所有评论(0)